采用烧结银工艺将芯片倒装烧结到DBC基板上,芯片背面采用铜夹连接,铜夹上连接散热器,形成芯片上表面的热通路。采用聚合物热界面材料在模块的上下表面连接两个陶瓷散热器,进行双面散热。由于芯片倒装键合面积只占芯片面积的很小一部分,接触面积较小成为限制该封装散热性能的关键。该封装中倒装芯片键合层和铜夹连接层对模块热性能的影响比连接散热器的热界面材料的影响更加明显。增大倒装芯片的键合面积有助于降低倒装芯片键合层的热阻,有利于降低芯片结温。研究表明,通过增大芯片电极金属化面积,如将芯片电极面积占比从22%提高到88%,采用倒装键合,芯片结温可降低20-30℃。建议可以通过采用扩大芯片电极金属化面积,增大键合面积的方式来降低热阻。在壳体灌胶与固化过程中,IGBT自动化设备能够确保完整的绝缘保护和固化效果。海南一体化无功老化测试设备

汽车IGBT模块要做哪些测试验证?汽车IGBT模块对产品性能和质量的要求要明显高于消费和工控领域,因此车规认证成为了汽车IGBT模块市场的重要壁垒,一般来说,车规级IGBT需要2年左右的车型导入周期。汽车IGBT模块测试标准主要参照AEC-Q101和AQG-324,同时车企会根据自己的车型特点提出相应的要求,主要测试方法包括:参数测试、ESD测试、绝缘耐压、机械振动、机械冲击、高温老化、低温老化、温度循环、温度冲击、UHAST(高温高湿无偏压)、HTRB(高温反偏)、HTGB(高温删偏)、H3TRB/HAST(高温高湿反偏)、功率循环、可焊性。网带式气氛烤炉生产IGBT自动化设备能够将多个IGBT芯片单元并串联起来,实现稳定的交流电输出。

由CMC制成的垫片可以传导电流、传递热量、保证电气绝缘距离,并具有与芯片和基板相匹配的可调节热膨胀系数(CTE)。交错平面封装方法通过增加相邻芯片间的距离来减小等效耦合热阻,拉长热耦合的传热路径,具有均匀且较小的热耦合效应。这种封装方式利用了3D封装结构灵活性的优势,增大传热距离,但没有增大功率模块的尺寸。具有低热耦合效应、更均匀的温度分布和出色的热性能。在相同的耗散热和散热条件下,与传统芯片布局封装模块至大结温155.8℃,封装内部至大温差12.3℃相比,交错布局封装至大结温为135.2℃,封装内部至大温差只3.4℃。显然,交错封装模块的温度分布更加均匀,可有效降低封装热阻和芯片间的热耦合不均匀程度。
无键合线单面散热:取消键合线有助于改善器件封装寄生电感和封装可靠性。超紧凑高可靠性SiCMOSFET模块,取消键合线和底板,将芯片直接焊接到基板上,采用铜针取代铝键合线,同时在高导热SiN陶瓷上设计了类似于热扩散器的更厚铜块,具有更好的传热效果。相比Al2O3陶瓷基板的键合线结构,采用Al2O3陶瓷的厚铜块封装模块结壳热阻降低37%,采用SiN陶瓷的厚铜块封装模块结壳热阻降低55%。同时该封装采用新型环氧树脂和银烧结技术,具有高达200℃的高温运行能力。动态测试IGBT自动化设备具备高频响应和准确采样能力。
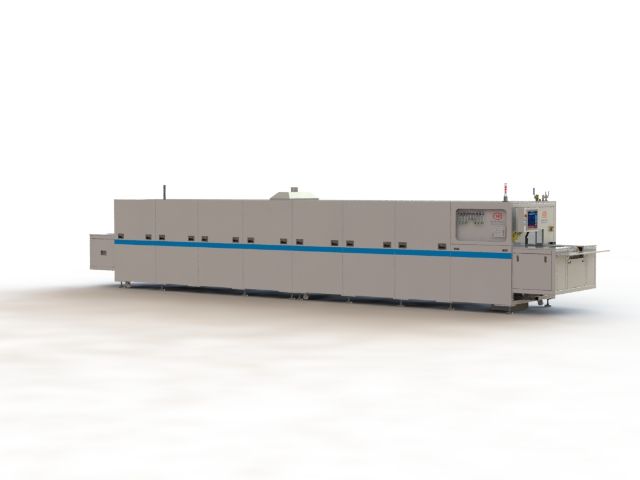
采用低温银烧结键合(LTB)技术将芯片对称布置在金属基复合(MMC)基板的中心安装孔四周,使模块与热沉间保持良好的电气接触和热接触。芯片正面的功率电极通过高熔点焊料连接到上部MMC基板,两个基板与芯片两个表面紧紧接触,芯片的两侧(芯片烧结层-MMC,芯片层焊料-MMC)均成为散热路径。虽然芯片正面的功率电极取消了键合线,但栅极仍需采用键合线连接。使用硅橡胶成型,使模块易于集成,同时满足爬电和间隙距离要求。该封装技术非常适合于需要冷却的高功耗器件。电动汽车的崛起加速了功率模块封装技术的更新,IGBT自动化设备也得到了迭代升级。网带式气氛烤炉生产
动态参数测试中,IGBT自动化设备能够对产品的响应速度和耐压能力进行精确评估。海南一体化无功老化测试设备
PBA封装双面散热比传统键合线连接单面散热热阻降低38%,表明PBA双面散热封装的优势。双DBC封装实现双面散热的研究还有很多,双面散热得益于芯片封装的两个表面平台,给连接DBC提供了可能,实现了两个散热路径。对比了双面散热结构与传统键合线连接单面散热结构的热性能对比,可以看出双面散热结构具有明显的优势。针对面连接,由于芯片栅极焊盘尺寸小和栅极位置,增加了芯片正面连接的难度。研究人员提出了栅极扩大的方法。通过对芯片的栅极焊盘进行再加工和扩大的再处理方法,增大栅极焊盘的面积,使得面接触更容易实现,进而获得双面散热路径,使该封装具备双面散热的能力。海南一体化无功老化测试设备