论文主要以半导体锗和贵金属金两种材料为对象 ,研究了白光干涉法、表面等离子体共振法和外差干涉法实现纳米级薄膜厚度准确测量的可行性。由于不同材料薄膜的特性不同,所适用的测量方法也不同。半导体锗膜具有折射率高,在通信波段(1550nm附近)不透明的特点,选择采用白光干涉的测量方法;而厚度更薄的金膜的折射率为复数,且能激发的表面等离子体效应,因而可借助基于表面等离子体共振的测量方法;为了进一步改善测量的精度,论文还研究了外差干涉测量法,通过引入高精度的相位解调手段,检测P光与S光之间的相位差提升厚度测量的精度。白光干涉膜厚仪是一种可用于测量薄膜厚度的仪器,适用于透明薄膜和平行表面薄膜的测量。防水膜厚仪产品使用误区
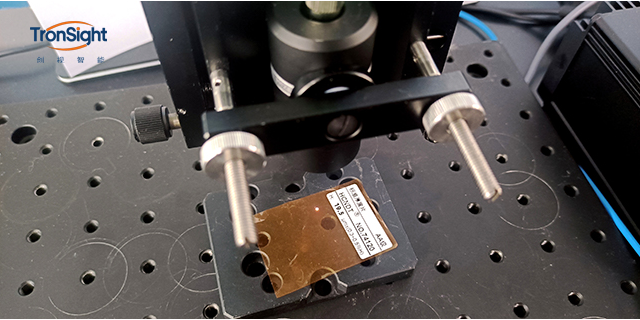
光谱法是以光的干涉效应为基础的一种薄膜厚度测量方法 ,分为反射法和透射法两类[12]。入射光在薄膜-基底-薄膜界面上的反射和透射会引起多光束干涉效应,不同特性的薄膜材料的反射率和透过率曲线是不同的,并且在全光谱范围内与厚度之间是一一对应关系。因此,根据这一光谱特性可以得到薄膜的厚度以及光学参数。光谱法的优点是可以同时测量多个参数且可以有效的排除解的多值性,测量范围广,是一种无损测量技术;缺点是对样品薄膜表面条件的依赖性强,测量稳定性较差,因而测量精度不高;对于不同材料的薄膜需要使用不同波段的光源等。目前,这种方法主要应用于有机薄膜的厚度测量。国内膜厚仪厂家现货白光干涉膜厚测量技术可以应用于光学元件制造中的薄膜厚度控制。

为限度提高靶丸内爆压缩效率 ,期望靶丸所有几何参数、物性参数均为理想球对称状态。因此,需要对靶丸壳层厚度分布进行精密的检测。靶丸壳层厚度常用的测量手法有X射线显微辐照法、激光差动共焦法、白光干涉法等。下面分别介绍了各个方法的特点与不足,以及各种测量方法的应用领域。白光干涉法[30]是以白光作为光源,宽光谱的白光准直后经分光棱镜分成两束光,一束光入射到参考镜。一束光入射到待测样品。由计算机控制压电陶瓷(PZT)沿Z轴方向进行扫描,当两路之间的光程差为零时,在分光棱镜汇聚后再次被分成两束,一束光通过光纤传输,并由光谱仪收集,另一束则被传递到CCD相机,用于样品观测。利用光谱分析算法对干涉信号图进行分析得到薄膜的厚度。该方法能应用靶丸壳层壁厚的测量,但是该测量方法需要已知靶丸壳层材料的折射率,同时,该方法也难以实现靶丸壳层厚度分布的测量。
光纤白光干涉测量使用的是宽谱光源 。光源的输出光功率和中心波长的稳定性是光源选取时需要重点考虑的参数。论文所设计的解调系统是通过检测干涉峰值的中心波长的移动实现的,所以光源中心波长的稳定性将对实验结果产生很大的影响。实验中我们所选用的光源是由INPHENIX公司生产的SLED光源,相对于一般的宽带光源具有输出功率高、覆盖光谱范围宽等特点。该光源采用+5V的直流供电,标定中心波长为1550nm,且其输出功率在一定范围内是可调的,驱动电流可以达到600mA。通过测量反射光的干涉来计算膜层厚度,利用膜层与底材的反射率和相位差来实现测量。

采用峰峰值法处理光谱数据时 ,被测光程差的分辨率取决于光谱仪或CCD的分辨率。我们只需获得相邻的两干涉峰值处的波长信息即可得出光程差,不必关心此波长处的光强大小,从而降低数据处理的难度。也可以利用多组相邻的干涉光谱极值对应的波长来分别求出光程差,然后再求平均值作为测量光程差,这样可以提高该方法的测量精度。但是,峰峰值法存在着一些缺点:当使用宽带光源作为输入光源时,接收光谱中不可避免地叠加有与光源同分布的背景光,从而引起峰值处波长的改变,引入测量误差。同时,当两干涉信号之间的光程差很小,导致其干涉光谱只有一个干涉峰的时候,此法便不再适用。白光干涉膜厚仪可以配合不同的软件进行分析和数据处理,例如建立数据库、统计数据等。防水膜厚仪厂家
操作需要一定的专业素养和经验,需要进行充分的培训和实践。防水膜厚仪产品使用误区
基于白光干涉光谱单峰值波长移动的锗膜厚度测量方案研究 :在对比研究目前常用的白光干涉测量方案的基础上,我们发现当两干涉光束的光程差非常小导致其干涉光谱只有一个干涉峰时,常用的基于两相邻干涉峰间距的解调方案不再适用。为此,我们提出了适用于极小光程差的基于干涉光谱单峰值波长移动的测量方案。干涉光谱的峰值波长会随着光程差的增大出现周期性的红移和蓝移,当光程差在较小范围内变化时,峰值波长的移动与光程差成正比。根据这一原理,搭建了光纤白光干涉温度传感系统对这一测量解调方案进行验证,得到了光纤端面半导体锗薄膜的厚度。实验结果显示锗膜的厚度为,与台阶仪测量结果存在,这是因为薄膜表面本身并不光滑,台阶仪的测量结果只能作为参考值。锗膜厚度测量误差主要来自光源的波长漂移和温度控制误差。防水膜厚仪产品使用误区