HERCULES光刻轨道系统技术数据:对准方式:上侧对准:≤±0.5µm;底侧对准:≤±1,0µm;红外校准:≤±2,0µm/具体取决于基材先进的对准功能:手动对准;自动对准;动态对准。对准偏移校正:自动交叉校正/手动交叉校正;大间隙对准。工业自动化功能:盒式磁带/SMIF/FOUP/SECS/GEM/薄,弯曲,翘曲,边缘晶圆处理曝光源:汞光源/紫外线LED光源曝光设定:真空接触/硬接触/软接触/接近模式/弯曲模式楔形补偿:全自动软件控制;非接触式曝光选项:间隔曝光/洪水曝光/扇区曝光系统控制操作系统:Windows文件共享和备份解决方案/无限制程序和参数多语言用户GUI和支持:CN,DE,FR,IT,JP,KR实时远程访问,诊断和故障排除新型的EVG120带有通用和全自动光刻胶处理工具,能够处理各种形状和尺寸达200 mm / 8“的基片。甘肃光刻机服务为先
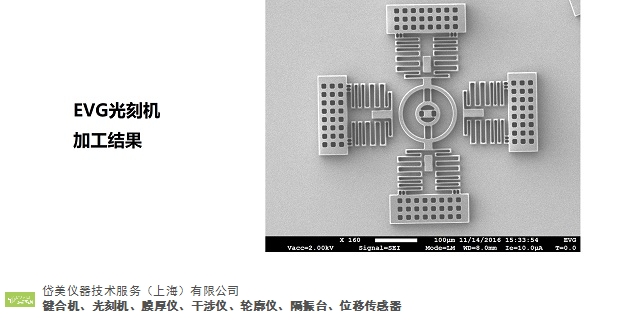
EVG101光刻胶处理系统的旋转涂层模块-旋转器参数转速:蕞高10krpm加速速度:蕞高10krpm喷涂模块-喷涂产生超声波雾化喷嘴/高粘度喷嘴;开发模块-分配选项水坑显影/喷雾显影EVG101光刻胶处理系统;附加模块选项:预对准:机械系统控制参数:操作系统:Windows文件共享和备份解决方案/无限制程序和参数/离线程序编辑器灵活的流程定义/易于拖放的程序编程并行处理多个作业/实时远程访问,诊断和故障排除多语言用户GUI和支持:CN,DE,FR,IT,JP,KR官方授权经销光刻机美元价EVG光刻机的掩模对准器和工艺能力经过客户现场验证,安装并集成在全球各地的用户系统中。

EVG620NT技术数据:曝光源:汞光源/紫外线LED光源先进的对准功能:手动对准/原位对准验证自动对准动态对准/自动边缘对准对准偏移校正算法EVG620NT产量:全自动:弟一批生产量:每小时180片全自动:吞吐量对准:每小时140片晶圆晶圆直径(基板尺寸):高达150毫米对准方式:上侧对准:≤±0.5µm底侧对准:≤±1,0µm红外校准:≤±2,0µm/具体取决于基材键对准:≤±2,0µmNIL对准:≤±3.0µm曝光设定:真空接触/硬接触/软接触/接近模式/弯曲模式楔形补偿:全自动软件控制曝光选项:间隔曝光/洪水曝光/扇区曝光系统控制:操作系统:Windows文件共享和备份解决方案/无限制程序和参数多语言用户GUI和支持:CN,DE,FR,IT,JP,KR实时远程访问,诊断和故障排除工业自动化功能:盒式磁带/SMIF/FOUP/SECS/GEM/薄,弯曲,翘曲,边缘晶圆处理纳米压印光刻技术:SmartNIL®
光刻机软件支持基于Windows的图形用户界面的设计,注重用户友好性,并可轻松引导操作员完成每个流程步骤。多语言支持,单个用户帐户设置和集成错误记录/报告和恢复,可以简化用户的日常操作。所有EVG系统都可以远程通信。因此,我们的服务包括通过安全连接,电话或电子邮件,对包括经过现场验证的,实时远程诊断和排除故障。EVG经验丰富的工艺工程师随时准备为您提供支持,这得益于我们分散的全球支持机构,包括三大洲的洁净室空间:欧洲(HQ),亚洲(日本)和北美(美国).可在众多应用场景中找到EVG的设备应用,包括高级封装,化合物半导体,功率器件,LED,传感器和MEMS。

EVG增强对准:全电动顶部和底部分离场显微镜支持实时,大间隙,晶圆平面或红外对准,在可编程位置自动定位。确保*好图形对比度,并对明场和暗场照明进行程序控制。先进的模式识别算法,自动原点功能,合成对准键模式导入和培训可确保高度可重复的对准结果。曝光光学:提供不同配置的曝光光学系统,旨在实现任何应用的*大灵活性。汞灯曝光光学系统针对150,200和300 mm基片进行了优化,可与各种滤光片一起用于窄带曝光要求,例如i-,g-和h-线滤光片,甚至还有深紫外线。HERCULES可以配置成处理弯曲,翘曲,变薄或非SEMI标准形状的晶片和基片。官方光刻机推荐厂家
HERCULES 全电动顶部和底部分离场显微镜支持实时、大间隙、晶圆平面或红外对准,在可编程位置自动定位。甘肃光刻机服务为先
EVG ® 150光刻胶处理系统分配选项:
各种光刻胶分配泵,可覆盖高达52000 cP的粘度
液体底漆/预湿/洗盘
去除边缘珠(EBR)/背面冲洗(BSR)
恒压分配系统/注射器分配系统
电阻分配泵具有流量监控功能
可编程分配速率/可编程体积/可编程回吸
超音波
附加模块选项
预对准:光学/机械
ID读取器:条形码,字母数字,数据矩阵
系统控制:
操作系统:Windows
文件共享和备份解决方案/无限制 程序和参数/离线程序编辑器
灵活的流程定义/易于拖放的程序编程
并行处理多个作业/实时远程访问,诊断和故障排除
多语言用户GUI和支持:CN,DE,FR,IT,JP,KR 甘肃光刻机服务为先