- 品牌
- RSP,TANAKA,Microhesion
- 型号
- TR191T1001
- 产地
- 日本
- 是否定制
- 是
TANAKA AuRoFUSE™在传感器和 MEMS(微机电系统)领域的应用展现了该技术在精密制造领域的巨大潜力。产品在 MEMS 等气密封装应用中表现出色,这主要得益于其独特的密封性能和热压工艺特性。在MEMS 气密封装应用中,AuRoFUSE™技术具有独特的优势。"AuRoFUSE™" 膏材所形成的密封外框,经热压(200℃、100MPa)使金粒子烧结体变形后,组织变得更加精密,从而实现高真空气密封装,氦气泄漏率可达 1.0×10^-13 Pa・m³/s。这一极高的密封性能对于需要高真空环境的 MEMS 器件至关重要。。。创新的烧结金胶,应用于光通信器件,无卤素配方。制备烧结金胶常见问题
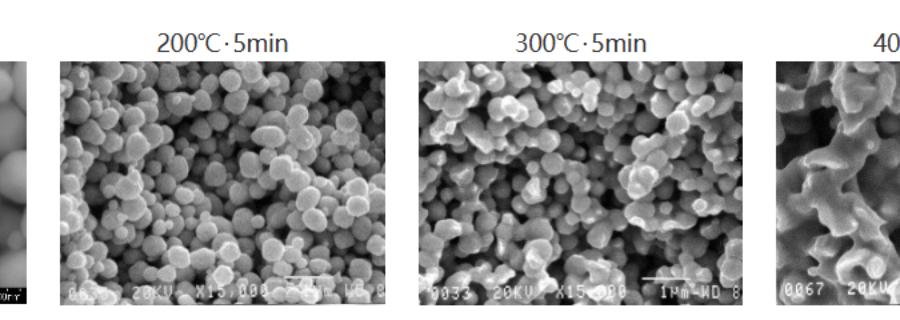
金胶中的金纳米粒子可作为活性成分,在特定条件下与材料表面发生化学反应或物理吸附,形成均匀、稳定的涂层。这种涂层可能赋予材料多种优异性能,如提高材料的耐腐蚀性、增强材料表面的生物相容性(对于生物医用材料)、改善材料的光学性能等。例如,在金属材料表面涂覆烧结金胶形成的涂层,金纳米粒子之间通过烧结过程形成紧密结合,能够有效阻挡腐蚀介质与金属基体的接触,从而提高金属材料的耐腐蚀性能。TANAKA烧结金胶在材料表面形成涂层时,金纳米粒子的聚集和烧结过程可能影响涂层的微观结构和性能,通过精确控制烧结条件,有望获得理想的表面涂层性能。。。123了解烧结金胶厂家电话高效的烧结金胶,提升导电性,用于 MEMS 气密封装。

TANAKA AuRoFUSE™在 LED 封装领域的应用是了该技术重要成功的商业化案例之一。与传统的引线键合方式不同,AuRoFUSE™采用面朝下(倒装芯片)键合技术,能够确保高散热性,同时提升电器性能,更能进一步制造出模组大小的小型化产品。在高功率 LED 模组应用中,AuRoFUSE™展现出了独特的技术优势。田中贵金属工业与 S.E.I 公司合作开发的高功率 LED 模组采用了以 "AuRoFUSE™" 为接合材料的面朝下接合结构,能够直接和金属基板接合。这一技术突是决了传统 LED 封装中的两个关键问题:散热性和热膨胀匹配。
TANAKA AuRoFUSE™在功率器件领域的应用具有重要的战略意义,特别是在下一代功率半导体技术的发展中扮演着关键角色。产品可作为光电半导体(LED 和 LD)、功率半导体、IC 用的芯片贴装材料,展现出了大方面的适用性。在第三代半导体器件应用中,AuRoFUSE™技术具有不可替代的优势。使用碳化硅(SiC)、氮化镓(GaN)的次世代功率半导体,操作温度有超过 300℃的情形。如果使用金 - 锡类焊料接合,材料将会熔融,但使用 "AuRoFUSE™" 接合,即使在 300℃高温下也能保持稳定的接合性能。先进的烧结金胶,应用于 LED 封装,具备高纯度金。

在热学性能方面,产品表现尤为突出。标准膏材的热导率大于 150W/m・K,预制件的热导率更是高达 200W/m・K。这种优异的热导率特性使得 AuRoFUSE™在需要高效散热的功率器件和 LED 应用中具有不可替代的优势。在机械性能方面,产品展现出了良好的柔韧性和强度平衡。标准膏材的杨氏模量为 9.5GPa,剪切强度为 30MPa;预制件的杨氏模量为 57GPa,剪切强度大于 30MPa。这种适中的机械性能既保证了良好的应力缓冲能力,又确保了足够的连接强度。产品的化学稳定性是其长期可靠性的重要保障。由于主要成分是具有高度化学稳定性的金,AuRoFUSE™预制件在贴装后也具有较好的可靠性。高效的烧结金胶,粒径分布均匀,用于 MEMS 气密封装。方便烧结金胶条件
烧结金胶独特的,在功率器件中使用,操作简便。制备烧结金胶常见问题
TANAKA 烧结金胶产品具有多项独特的技术特点,这些特点构成了其在市场竞争中的重要优势。首先,产品采用不含高分子等的球状次微米 Au 粒子,在约 150℃无压下即可开始烧结。这种低温烧结特性不仅降低了能耗,还避免了高温对器件的热损伤。其次,产品具有灵活的烧结模式选择:无压烧结时可获得多孔烧结体,通过加压可获得致密的 Au。这种双重模式设计为不同应用场景提供了定制化的解决方案,既可以满足需要应力缓冲的应用,也可以满足需要高导热性的应用。制备烧结金胶常见问题
- 哪些新型烧结金胶哪些需求 2025-10-16
- 特种烧结金胶检测 2025-10-15
- 新型烧结金胶费用是多少 2025-10-15
- 哪些新型烧结金胶供应商家 2025-10-15
- 实验室烧结金胶用途 2025-10-15
- 如何分类烧结金胶工艺 2025-10-15






